碳化硅(SiC)是用于电子设备中高温,高频和高功率应用的非常有前途的材料。然而,由于存在各种各样的扩展缺陷,许多基于SiC的电子设备的商业化一直是非常具有挑战性的。为了提高SiC的性能,已经进行了关于晶体生长期间缺陷的形成和传播的大量研究。尽管结果为技术的重大进步做出了贡献,促进了这些材料的商业化,但扩展缺陷的形成和扩散尚未得到完全了解。
尽管SiC中存在各种不同的扩展缺陷,但其中最有害的三个是螺纹位错,向内生长的堆垛层错和复合诱导的堆垛层错(RISF)。尤其是,RISF一直难以管理,因为它们在器件工作期间会膨胀,并导致双极器件(例如Pin二极管)的导通电压不断增加。通过在RISF附近重组自由载流子来诱导扩增。了解他们的运动机制无异于缓解他们。
电致发光通常用于识别扩展的缺陷:RISF在2.89 eV(430 nm) 处发出紫光,而束缚缺陷区域的部分位错在1.8 eV(690 nm)处发出红光。在4H-SiC中,最近还观察到部分位错在器件工作期间沿着碳核部分位错发展出绿色发光。即使RISF通过退火收缩,该发射仍会保留。视频1显示了RISF如何沿各种电流注入时间扩展,以及绿色发光中心如何沿部分位错移动。这意味着不仅RISF确实会在SiC内的载流子注入下移动,而且点缺陷(例如硼杂质)也会在这种条件下移动。
专门设计用于研究电致发光材料的IMA-EL™,Photonetc高光谱成像仪用于同时获取缺陷的光谱和空间信息。这种出色的技术可以快速,准确地识别导致4H-SiC绿色发射的缺陷类别。

在连续运行器件并随后在700ºC的氮气氛中退火以收缩RISF之后,对SiC pin二极管进行了电致发光成像(图1a)。再次扩展RISF之后,以 2 nm 的步长和30 s 的曝光时间在400-780 nm的光谱范围内收集了器件的电致发光。使用IMA™收集的单色图像可以分离各种类型的缺陷。特别是,图1b显示了以424 nm 为中心的RISF的峰值发射,图1c-d显示了534 nm和720处的部分位错。
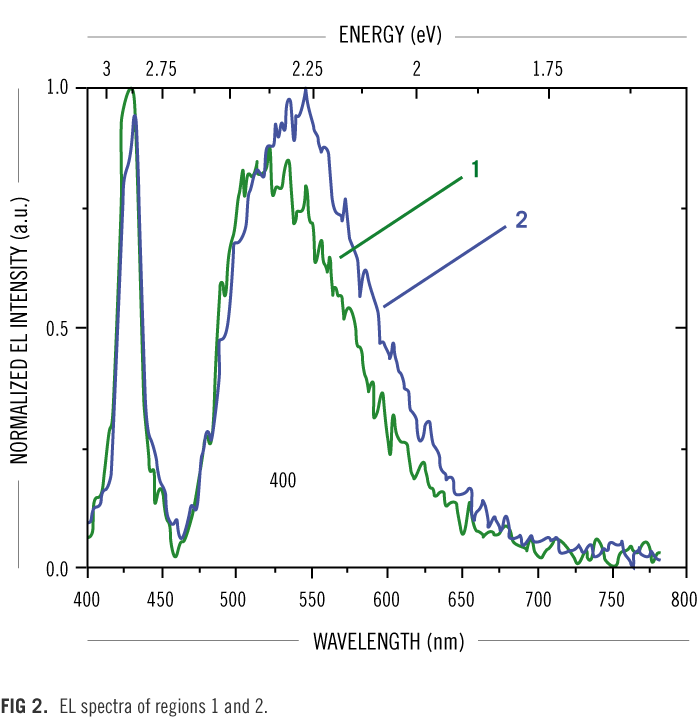
纳米 标记为“ 1”和“ 2”(图2)的两个区域的光谱响应证实,由于RISF,PD在424 nm处显示出相似的尖锐发射,而在530-540 nm处显示出更宽的发射。结合光谱和空间信息,可以将后者的发射归因于移动的硼杂质。
Photonetc的高光谱成像仪对于识别各种类型的断层的发光带至关重要,它将使人们更好地理解缺陷的形成及其在SiC材料中的传播。
Further reading on RISFs and their expansion and contraction:
J.D. Caldwell, R.E Stahlbush, K.D. Hobart, O.J. Glembocki, and K.X. Liu Appl. Phys. Lett. 90, 143519 (2007).
J.D. Caldwell, O.J. Glembocki, R.E. Stahlbush, and K.D. HobartAppl. Phys. Lett. 91, 243509 (2007).
J.D. Caldwell, R.E. Stahlbush, M.G. Ancona, O.J. Glembocki, and K.D. Hobart J. Appl. Phys. 108, 044503 (2010).
碳化硅缺陷表征
该视频显示了使用光子等的发光成像系统可以轻松检测到的各种类型的SiC缺陷。Photon等的高光谱成像技术可提供光谱分辨图像,从而提高了材料开发能力。
